自上世纪60年代以来,硅一直是半导体行业的"黄金材料",但随着晶体管尺寸逼近3纳米节点,量子隧穿效应和热耗散问题日益凸显,使得著名的“摩尔定律”走向终结。据国际器件与系统路线图(IRDS)预测,传统硅基技术将在2030年后面临性能天花板,无法满足算力增长需求。科学家们急需寻找一种兼具高迁移率、低功耗和原子级厚度的新材料,而二维半导体因原子级厚度和独特的电学特性成为“后摩尔时代”的希望。其中,硒化铟(InSe)凭借以下理论优势脱颖而出:超高电子迁移率,室温理论值1000 m2/V•s,远超硅的500 cm2/V•s;较高的热速度(>1.3 cm/s),优于硅的1.2 cm/s;低有效质量(0.14 m0),仅为硅的74%,可大幅降低器件工作电压;合适的带隙(1.26 eV)。尽管机械剥离的InSe微米薄片已展示出卓越性能,但此种方法产量有限,仅能用于实验室研究,难以满足集成电路制造所需的高质量晶圆级材料需求。而现有可工业化的薄膜生长技术(如化学气相沉积)制备的InSe晶圆存在相纯度低、结晶性差、器件均匀性不足等问题,导致此前报道的InSe薄膜器件性能甚至不及过渡金属硫化物,成为制约其产业应用的最大瓶颈。究其原因,硒(Se)和铟(In)的物理性质差异巨大,在500 °C生长温度下,硒的蒸汽压比铟高7个数量级,极易导致化学计量比偏离1:1,而微小的组分波动会引发杂相,大幅降低材料性能。此外,传统气相沉积法(如MOCVD、MBE)难以在晶圆尺度实现单晶生长,导致薄膜缺陷密度居高不下。
近日,北京大学刘开辉教授(点击查看介绍)领衔的联合团队突破了二维半导体晶圆级集成制造的关键瓶颈,他们发展了一种固-液-固(SLS)策略,通过创建富铟的液体界面并保持严格的1:1铟硒化学计量比,将非晶态硒化铟薄膜转化为纯相、高结晶度的硒化铟晶圆。所得的硒化铟薄膜在约5厘米尺寸的整个晶圆上表现出优异的均匀性、纯相和高结晶度。基于所生产的硒化铟晶圆的晶体管阵列表现出卓越的电子性能,包括极高的迁移率(平均高达287 cm2/V•s),接近玻尔兹曼极限的开关性能(亚阈值摆幅平均低至67 mV/dec),以及78%的弹道输运率,创造了同类二维半导体器件的新记录,核心电学指标超过了当前先进的 3 纳米硅基器件。相关成果近日发表于Science 期刊,北京大学物理学院刘开辉教授、北京大学电子学院姜建峰博士、邱晨光研究员和中国人民大学物理学院刘灿副教授为论文通讯作者,北京大学博士毕业生秦彪和姜建峰博士为论文共同第一作者。
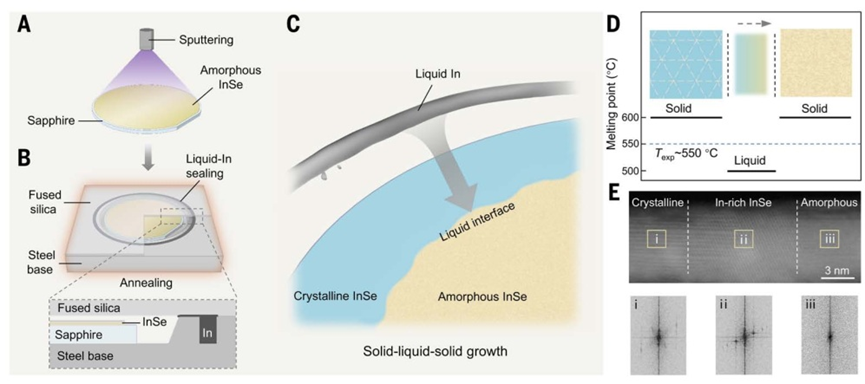
图1. 用于InSe晶圆生长的SLS策略。图片来源:Science
了避免杂相的形成,该团队通过密封预沉积非晶态InSe晶圆来保持严格的1:1铟硒化学计量比(图1)。首先,采用磁控溅射在5厘米蓝宝石衬底上沉积非晶态InSe薄膜;然后将该InSe薄膜置于定制钢槽中,覆盖熔融石英板,边缘用液态铟(熔点157°C)密封形成封闭生长环境,以避免后续过程中的原子损失并保持铟硒化学计量比;在550 °C退火时,密封腔内的饱和铟蒸气形成富铟液态界面,使非晶InSe薄膜中的铟和硒原子先溶解于液体界面随后再重结晶,得到高结晶度的InSe晶圆。这种固-液-固生长机制也得到了理论计算及实验表征结果的证实。密度泛函理论计算结果表明,晶体InSe比非晶InSe能量低0.38 eV/原子,驱动自发结晶;而扫描透射电镜(STEM)则直接观察到4 nm厚的富铟液态界面(图1E)。
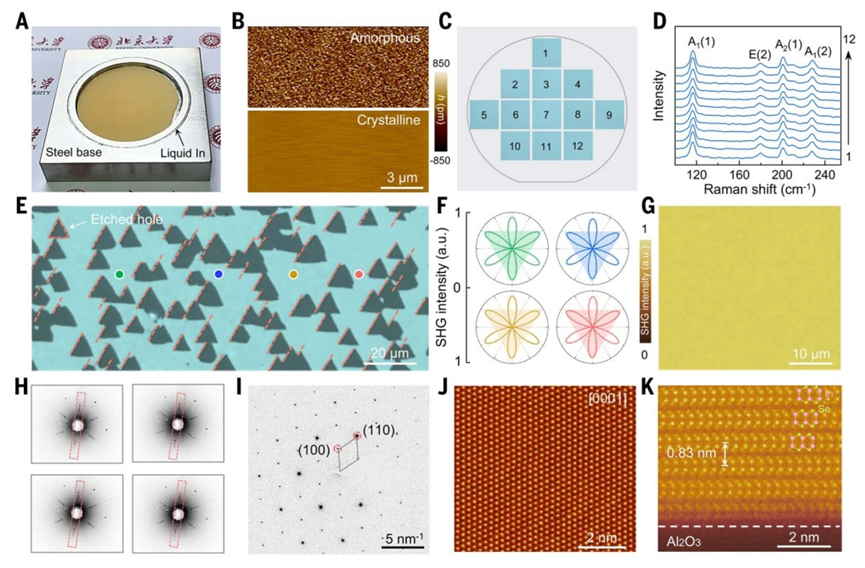
图2. InSe薄膜的表征。图片来源:Science
基于此固-液-固策略,该团队生长了尺寸约5 cm的高结晶度InSe晶圆(图2A),并通过多种手段对该InSe薄膜进行了表征。原子力显微镜(AFM)显示粗糙度从非晶态的415 pm降至结晶态的37 pm(图2B);12个采样点的拉曼光谱峰位偏差<0.5 cm-1(图2C-D),证实5厘米晶圆具有全域均匀性。氢刻蚀产生的三角形孔洞(图2E)和偏振依赖二次谐波成像(图2F)证实了5厘米晶圆的单晶一致性,劳厄X射线衍射(LXD)结果也证明了该晶圆在整个晶圆范围内的高结晶度(图2H)。高角环形暗场STEM(HAADF-STEM)显示面内三角晶格(层间距0.34 nm)和面外ABC堆叠(层间距0.83 nm)(图2J-K),与机械剥离单晶结构一致。

图3. 二维InSe FET的晶圆制程及电学性能统计。图片来源:Science
为了进一步评估InSe薄膜的晶体质量,该团队使用所制得的5 nm厚的InSe晶圆直接在蓝宝石衬底上制造了场效应晶体管(FET)大规模集成阵列,并分析了其电学性能(图3)。其中,他们通过稀土元素钇(Y)掺杂实现欧姆接触,解决二维材料常见的费米能级钉扎问题,并使用超薄2.6 nm HfO2作为介电层。对100个晶体管的测试显示,平均场效应迁移率为287 cm2/V•s,峰值347 cm2/V•s,创薄膜基二维器件纪录;亚阈值摆幅为67.3 mV/dec,逼近玻尔兹曼极限(60 mV/dec)。此外,该团队还将InSe器件(红色星号)的性能与其他材质器件进行了比较,InSe器件显著优于基于MoS2、WS2等材质的器件。
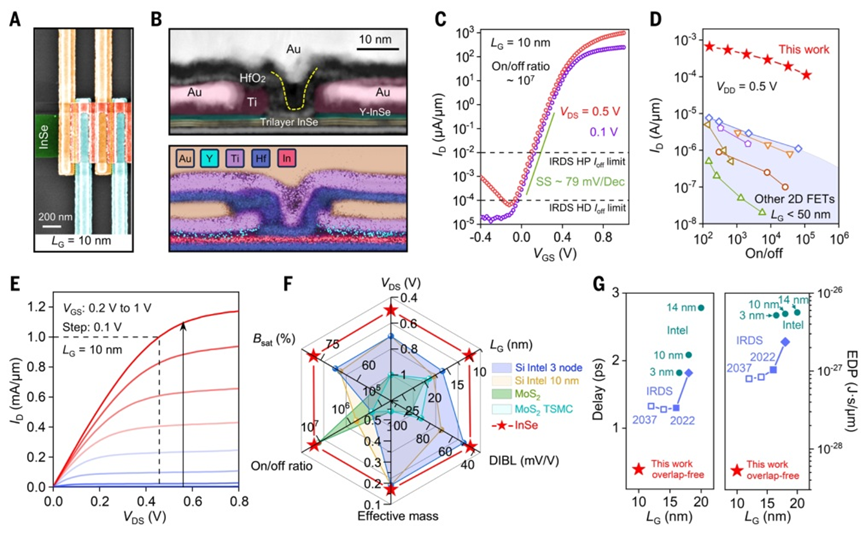
图4. InSe FET的短沟道电学性能。图片来源:Science
最后,该团队使用Y掺杂接触和双栅极结构(顶栅5 nm + 背栅10 nm)制造了沟道长度为10 nm的弹道InSe晶体管,并评估了其弹道输运性能。测试结果表明,0.46 V工作电压下电流密度达1 mA/μm;DIBL值低至22 mV/V,优于Intel 3纳米节点技术;本征门延迟仅为0.39 ps;能量延迟积(EDP)为5.27×10-29 J•s/μm,低于IRDS 2037年预测极限。六维性能雷达图(电压、栅长、DIBL、有效质量、开关比、弹道输运率)全面超越现有技术(图4F)。
小结
北京大学物理学院刘开辉教授带领的联合科研团队发展了创新性的固-液-固密封生长策略,通过创建富铟的液体界面并保持严格的1:1铟硒化学计量比,将非晶态硒化铟薄膜转化为纯相、高结晶度的硒化铟晶圆。所得的硒化铟薄膜在约5厘米尺寸的整个晶圆上表现出优异的均匀性、纯相和高结晶度,基于该晶圆的晶体管阵列表现出卓越的电子性能,延迟性能和能效指标上全面超越半导体技术路线图预测的硅基极限。